-

PECVD等离子增强化学气相沉积系统
系统特点:多层匀气结构,加热温度60-400℃,600℃可选,金属密封嵌套腔室,气路SiH4/NH3/N2O/CH4等¥ 0.00立即咨询
-
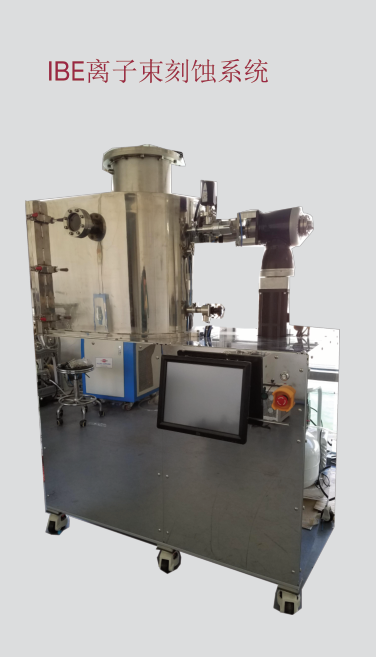
IBE离子束刻蚀系统
系统特点:样片放置:旋转式杨平托盘、反应腔室:304不锈钢、氩离子源:160mm,考夫曼型离子源、载样基台:具备旋转功能,工业电机、阀门系统:高真空插板阀(可进行位置预设控压)、真空系统:600L/s分子泵,机械泵组成、真空测量:薄膜规,压力传感器、温控系统:循环水冷、气路系统:标配1路气体,高精度流量计,可根据需求定制多路气体、界面操作:触摸屏操作,菜单自动/手动操作、控制系统:工控机+工业办卡、安全控制:异常报警、刻蚀材料:金属等适用性材料、真空性能:本底真空<5.0x10-4Pa、设备尺寸:可根据需求定制化生产¥ 0.00立即咨询
-
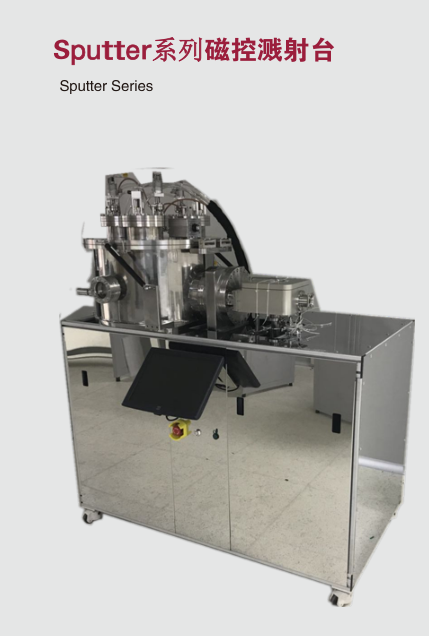
Sputter系列磁控溅射台
系统特点:标准3靶位,可同时溅射两种金属,多层复合膜溅射,金属共溅射或反应溅射、基片台可旋转,特别适合于用剥离技术制作难腐蚀金属的亚微米图形(如Au、Pt、Ta、超导材料等)、标准6英寸装载,兼容小片,基片可以烘烤、射频与直流两种电源配置,金属及非金属薄膜均可溅射、可根据用户需求定制。¥ 0.00立即咨询
-

原子层沉积系统
系统特点:样品台标准4英寸,兼容小尺寸,可根据使用需求定制、基片加热温度室温-350℃(可选配高温)、前驱体输运系统标准2路液态前驱体管路,可预留、前驱体管路温度室温-150℃、源瓶加热温度室温-150℃、ALD阀Swagelok快速高温ALD专用阀、本底真空<5*10-5Torr,高性能机械泵+分子泵、载气系统N2或者Ar、生长模式高速沉积模式和停留生长模式、等立子体源0-300w 感应耦合远程等离子体(可选)、等离子体放电气源标准2-4路,可选配、控制系统PLC+触摸屏¥ 0.00立即咨询
-

键合机
系统特点:阳极键合@≤1200V、满足定制化小样品键合、键合气压≥50Torr、可调节性施加外部压力、温度≤250℃、不通气氛下键合、可实现气氛下手动对准功能、整片键合可定制、高温条件可定制¥ 0.00立即咨询
-

ICP系列高密度等离子刻蚀系统
系统特点:6英寸向下兼容,可扩展到8英寸至12英寸,深硅刻蚀工艺、硅基材料/蓝宝石/金属/GaN等、自动化工艺、腔室控温、自动化传片预腔室、可根据被刻蚀样品进行测试及定制特殊需求。¥ 0.00立即咨询
-

RIE系列反应离子刻蚀系统
系统特点: 反应离子、水冷、自动化工艺、多路气体等,可根据需求进行定制化生产。¥ 0.00立即咨询
-

12寸晶圆倒片机
全自动12英寸晶圆倒片机(ALI-300 Wafer Sorter),主要用于晶圆的自动传送、定位和排序。
ALI-300 Wafer Sorter整机采用模块化设计,整机符合SEMI 标准。
设备配有自主知识产权的单臂单叉机械手模块、预对准模块和ID Reader模块,三模块在水平方向上同步运动,可在晶圆传输的过程中实现对晶圆缺口的检测及ID的读取,提高了Sorter的传片效率。
设备同时配置高效FFU,采用全封闭结构,具有超洁净性能,其洁净度达Class1。¥ 0.00立即咨询