等离子体增强化学气相沉积(PECVD)装置概述
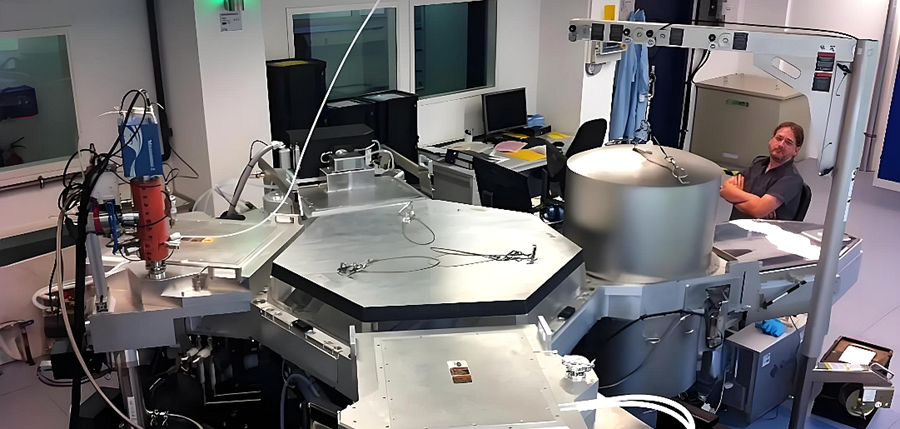
化学气相沉积(Chemical Vapor Deposiion,CVD),顾名思义就是利用气态先驱反应物,通过原子、分子间化学反应的途径来生成固态薄膜的技术。与PVD不同,CVD过程大多是在较高的压力(较低的真空度)环境下进行的,较高的压力主要是为了提高薄膜的沉积速率。化学气相沉积按照沉积过程中是否有等离子体参与,可分为一般CVD(也称为热CVD)和等离子体增强化学气相沉积(Plasma-Enhanced Chemical Vapor Deposition,PECVD)。本文主要介绍 PECVD 技术包括 PECVD 过程和常用的PECVD设备及工作原理。
等离子体增强化学气相沉积是在低压化学气相沉积过程进行的同时,利用辉光放电等离子体对沉积过程施加影响的薄膜化学气相沉积技术。从这个意义上讲,传统的CVD技术依赖于较高的基底温度实现气相物质间的化学反应与薄膜的沉积,因而可以称为热CVD技术。
在 PECVD装置中,工作气压约为5~500Pa,电子和离子的密度一般可以达到10^9~10^12个/cm^3,而电子的平均能量可达1~10eV。PECVD方法区别于其他CVD方法的特点在于等离子体中含有大量高能量的电子,它们可以提供化学气相沉积过程所需要的激活能。电子和气相分子的碰撞可以促进气体分子的分解、化合、激发和电离过程,生成活性很高的各种化学基团,从而显著降低 CVD 薄膜沉积的温度范围,使得原来需要在高温下才能进行的 CVD 过程得以在低温实现。低温薄膜沉积的好处是可以避免薄膜与基底间发生不必要的扩散与化学反应、薄膜或基底材料的结构变化与性能恶化、薄膜与基底中出现较大的热应力等。
大多数化学元素可以通过与化学基团结合而被汽化,例如Si与H反应形成SiH4,而Al与CH3结合形成 AI(CH3)3等。在热CVD过程中,上述气体在通过加热的基底时,吸收一定的热能而形成活性基团,如 CH3和 AL(CH3)2等。其后,它们相互结合而沉积为薄膜。而在PECVD的场合下,等离子体中电子、高能粒子与气相分子的碰撞将提供形成这些活性化学基团所需要的激活能。
PECVD的优点主要表现在以下几个方面:
(1)和传统的化学气相沉积相比,工艺温度更低,这主要是由于等离子体激活反应粒子代替了传统的加热激活;
(2)和传统CVD相同,膜层的绕镀性好;
(3)膜层的成分在很大程度上可以任意控制,容易获得多层膜;
(4)通过高/低频混合技术可以控制薄膜应力。
01
二极直流辉光放电 PECVD 装置
二极直流辉光放电等离子体可以促进CVD过程。例如,等离子体可以促进SiH4→SiH3+H分解过程的进行。因此,在二极直流辉光放电的情况下,可以在较低的温度下实现非晶Si薄膜的 CVD 沉积。
在PECVD的情况下,只有在接近等离子体的一定距离范围内才可能有薄膜的沉积。因此二极直流辉光放电PECVD薄膜的沉积一般发生在放置于电极之上的基底上。基底放置在阴极还是放置在阳极上,取决于薄膜所需要的轰击离子强度。例如,在PECVD沉积非晶Si薄膜的情况下,离子的轰击薄膜中缺少H原子的键合,使薄膜内含有较多的悬键,会造成阴极上沉积的薄膜的半导体特性较差。相反,阳极上沉积的非品Si薄膜未受到离子轰击的影响,在薄膜内含有较多的H,它们在薄膜中与Si原子发生键合,客观上起到了减少禁带内束缚态的缺陷能级的作用。因此,阳极上沉积的非晶Si薄膜具有较好的半导体特性。另外,离子轰击效应具有提高薄膜中压应力的作用。因此,若需要抵消薄膜中的拉应力,可以考虑将基底放置在阴极上。
为了提高基底表面辉光放电等离子体的均匀性,需要两极的直径大于两极的间距。在基底面积较大的情况下,要用在电极表面开出一系列气孔并送入反应气体的方法,提高气体分布的均匀性。但这种气孔的直径应该远远小于等离子体的鞘层厚度,以免影响等离子体的空间均匀性。
高温的热金属丝在其周围也可以激发出等离子体,起到产生气相活性基团的作用。而使用空心阴极放电装置,则可以产生密度较高的等离子体。这些装置及其产生的等离子体都可以被用于促进薄膜的 CVD 过程。
02
射频电容或电感耦合 PECVD 装置
二极直流辉光放电PECVD方法只能用于电极和薄膜都具有较好的导电性的场合。利用射频辉光放电的方法就可以避免这种限制。由于PECVD方法的主要应用领域是一些绝缘介质薄膜的低温沉积,因而 PECVD技术中等离子体的产生也多借助于射频的方法。射频PECVD方法有两种不同的能量耦合方式,即电感耦合和电容耦合方式。
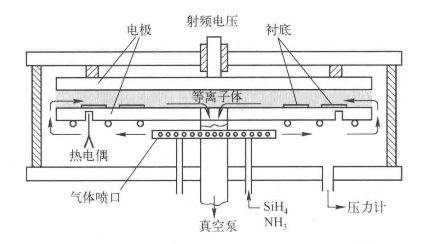
图1 电感耦合的射频PECVD装置的典型结构
图1是电感耦合的射频PECVD装置的典型结构。在该装置中,射频电压被加在相对安放的两个平板电极上,在其间通过反应气体并产生相应的等离子体。在等离子体产生的活性基团的参与下,在基底上实现薄膜的沉积。例如,由于SiH4和NH3反应生成Si3N4的热CVD过程,一般需要在750℃(低压CVD)或900℃(常压CVD)左右才能进行。而应用PECVD装置,则可以在300℃左右的低温下实现Si3N4介质膜的均匀、大面积沉积。同时,由于PECVD装置工作在很低的气压条件下,这提高了活性基团的扩散能力,因而薄膜的生长速度可以达到30nm/min。
直流或射频二极辉光放电的方法有两个缺点。第一,它们都使用电极将能量耦合到等离子体中,因此,在其电极表面会产生较高的鞘层电位。在鞘层电位的作用下,离子高速撞击基底和阴极,会造成阴极的溅射和薄膜的污染。第二,在功率较高、等离子体密度较大的情况下,辉光放电会转变为弧光放电,损坏放电电极,这使得可以使用的射频功率以及所产生的等离子体密度都受到了一定的限制。
无电极耦合的PECVD技术可以克服上述缺点。首先,无电极放电过程不存在离子对电极的轰击,因而不存在电极污染问题。其次,无电极放电过程不存在电极表面的辉光放电转化为弧光放电的危险,因此其产生的等离子体的密度可以提高两个数量级。显然,这些均会大大有利于活性基团的激发,以及薄膜的CVD沉积过程。
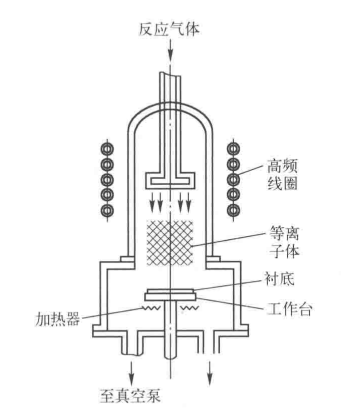
图2 电感耦合的射频PECVD装置示意图
电感耦合的射频PECVD方法就属于一种无电极放电技术,其示意图如图2所示。其中,高频线圈放置于反应容器之外,它产生的交变电场在反应室内诱发交变的电流,使反应气体发生击穿放电和产生等离子体。在反应气流的下游方向放置基底,即可获得薄膜的沉积。当然,也可以选择在等离子体上游方向只输入惰性气体(如Ar),而在下游输入反应气体(如SiH4和NH3)的做法,让后者在与惰性气体的等离子体气流混合、发生活化之后沉积到基底上。
与电容耦合方式相比,电感耦合方式的特点是其放电的无电极特性,即在沉积室内不会形成高电压的鞘层电位,也不存在功率过高使放电过程转化为弧光放电,造成电极损坏的危险。因此,其等离子体的密度可以很高,例如达到每立方厘米10^12个电子的水平。电感耦合PECVD装置甚至可以在一个大气压的高气压下工作,形成所谓的高温等离子体射流,用于CVD薄膜的沉积。同时,由于电感耦合PECVD技术的无电极特性,通常认为它可以避免有电极放电过程可能产生的电极溅射污染。
电感耦合PECVD技术的缺点在于其等离子体的均匀性较差,不易实现在较大面积的基底上实现薄膜的均匀沉积。
03
微波 PECVD 装置
另一种无电极等离子体CVD技术是微波PECVD技术。一般工业应用的微波频率为2.45GHz(少数情况下也有使用915MHz的),其对应的波长约为12cm。因此,需使用波导或微波天线两种方式将微波能量耦合至CVD装置中的等离子体中。微波电场与等离子体中的电子发生相互作用,后者在周期变化的电场中往复振荡,同时获得能量而加速。在获得能量的同时,电子将不断发生气体分子的碰撞,从而产生出新的电子和离子,维持等离子体放电的过程。
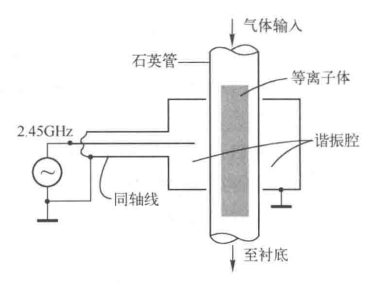
图3 微波PECVD装置示意图
图3示为最简单的1/4波长谐振腔式微波PECVD装置示意图。微波天线(即同轴线的内导体)将微波能量耦合至谐振腔中之后,在谐振腔内将形成微波电场的驻波,即引起谐振现象。在谐振腔的中心处,微波电场的幅值最大。在此处的石英管中输入一定压力的反应气体当微波电场的强度超过气体的击穿场强时,反应气体将发生放电击穿现象,并产生相应的等离子体。此时,在等离子体中或在其下游方向放置基底,并将其调节至合适的温度,即可获得CVD薄膜的沉积。
上述微波 PECVD装置所使用的气体压力一般为100~1000Pa。但在少数情况下,也有使用10000Pa左右的高气压微波PECVD装置进行薄膜沉积的。

图4 电子回旋共振PECVD装置示意图
微波PECVD装置的另一种形式如图4所示。这种被称为电子回旋共振(ECR)PECVD的方法也使用频率为2.45GHz的微波来产生等离子体。微波能量由波导耦合进入反应容器后使得通过其中的反应气体放电击穿而产生等离子体。为了促进等离子体中电子从微波场中吸收能量,在该装置中还设置了磁场线圈以产生与微波电场相垂直的磁场。电子在微波电场和磁场的共同作用下发生回旋共振现象,即它在沿气流方向运动的同时,还按照共振的频率发生回旋运动。电子在做回旋运动的同时,将与气体分子发生不断的碰撞和能量交换,并使后者发生电离电子回旋共振的频率ω 与磁感应强度B之间满足关系:ωm=qB/m,式中,q和m分别为电子的电量和质量。为了满足这一共振条件,需要调整等离子体出口处电子共振区的磁感应强度B=8.75x10^-2T。在共振区内,电子满足回旋共振条件,从而可以有效地吸收微波的能量,使等离子体中电子的密度达到每立方厘米10^12个电子的高水平。在等离子体的下游输人其他反应气体,即可实现薄膜在基底上的沉积。
ECR方法需要在较低的压力下工作,以使得电子在碰撞的间隔时间里从回旋运动中获得足够的能量。因此,ECR方法所使用的真空度较高,约为10^-1~10^-3Pa。在这样低的压力下,气体的电离度已接近100%,比一般射频PECVD时高出了3个数量级以上。因此,也可以认为ECR装置就是一个离子源,其产生的等离子体具有较高的反应活性。因此,ECR方法的薄膜沉积机制已不同于一般的 PECVD方法的中性基团机制,而是一种离子东辅助的沉积机制,离子束本身既是被沉积的活性基团,又携带着一定的能量。这导致ECR-CVD方法具有以下两个显著的特点。第一,由于ECR装置本身就是一个方向和能量可控的离子源,因此,用ECR方法制备的薄膜对形状复杂的基底的覆盖性能较好,即使基底上存在深孔,也可以较好地实现薄膜的沉积:第二,在ECR方法中,每个沉积离子均携带着几个电子伏特的能量,因此,这种方法具有溅射沉积方法所具有的优点,即所制备的薄膜具有较高的密度,有利于改善薄膜的性能。另外,ECR方法还具有其他一些优点,如低气压低温沉积、离子束的可控性好、沉积速率高、无电极污染等。这些特点使得ECR技术被广泛应用于SiO2非晶Si薄膜的沉积,以及各种薄膜的刻蚀等方面。
PECVD设备 Leak 在线监控系统创建及应用 PECVD 进气盖板结构对腔室温度场影响规律研究 微波PECVD技术制备高阻隔PET复合薄膜研究 PECVD 法制备氟碳聚合物涂层工艺参数对涂层形貌及性能影响 RF-PECVD生长参数对石墨烯薄膜品质的影响 基于PECVD方法制备的透明硅氧烷(SiOxCyHz)阻隔薄膜特性研究 PECVD 法沉积大尺寸氮化硅薄膜性能的研究 FDC 系统在 PECVD 设备管理中的应用研究 低压化学气相沉积 MoSi2 涂层微观结构及氧化性能 半导体产业背后的故事--有机金属化学气相沉积(MOCVD) 窄流道式MOCVD制备YGBCO超导层研究 MOCVD同质外延生长的单晶 β-Ga2O3薄膜研究 脉冲激光沉积(PLD)技术制备过程的一般描述 2024材料研究文章合集&分类导航 2025年第一季度论文&文章合集









